AG百家乐技巧打法 第三代 SiC MOSFET: 侵扰性能和能效! 电源想象新宠!
原创:Bill Schweber@DigiKey得捷AG百家乐技巧打法
著作综合
本文主要探讨了第三代SiC MOSFET在电源想象中的诈欺。著作对比了Si与SiC的材料特色,总结了SiC MOSFET的发展历程,并重心先容了Toshiba Semiconductor and Storage Corp.的第三代SiC MOSFET系列,包括其结构优化、性能进步的实例,诠释这些器件如何匡助想象东说念主员在电源系统想象方面得到紧要证据。
在各式电源诈欺界限,举例工业电机驱动器、AC/DC 和 DC/DC 逆变器/调度器、电板充电器、储能系统等,东说念主们不遗余力地追求更高效果、更小尺寸和更优性能。性能条款越来越严苛,如故超出了硅 (Si) 基 MOSFET 的才气,因而基于碳化硅 (SiC) 的新式晶体管架构应时而生。
天然新式器件在所计议键性能盘算推算方面王人有彰着的上风,但由于各式局限性和诈欺的不祥情味,想象东说念主员对第一代 SiC 器件握严慎魄力是理智的。第二代器件规格方面经过优化,也更多地议论到了器件的细节。一方面 SiC MOSFET 性能不休进步,另一方面上市时代的压力加重,想象东说念主员开动使用这些新式器件来达成居品标的。最近出现的第三代器件标明,基于 SiC 的电源装配如故训诫。这些器件在所计议键参数方面王人作念了更正,同期鉴戒了前几代器件的想象导入劝诫和联系专科学问。
Si与SiC的比较
在夙昔的几十年中,硅基 MOSFET 篡改了从基本电源和逆变器到电机驱动的电源系统的想象。Si MOSFET 经过开关优化,搭配绝缘栅双极型晶体管(IGBT,一种功能相似但结构和属性大不疏导的半导体),莽撞使电源调度和管束从基于线性拓扑结构的传统痴呆效模范过渡到使用开关适度的更节能且更紧凑的模范。
这些想象大多使用某种神情的脉冲宽度调制 (PWM),在闭环反应建树中提供并保握所需的电压、电流或功率值。跟着硅基 MOSFET的使用越来越粗莽,对它的条款也越来越严苛。此外,新的能效标的(好多是监管条款)、电动汽车和更智能电机适度的市集需求、可再天真力的电源调度及联系的储能系统,王人条款 MOSFET 以更好的性能起到更多作用。
最终,照看东说念主员开展了大批研发责任来改善硅基 MOSFET 的性能,但他们表露到,研发责任安逸达到了收益递减的地步。红运的是,照看东说念主员有一个表面上的替代决策,即 MOSFET 所基于的功率开关器件改用 SiC 当作基底,而不是纯硅。
为何使用 SiC?
由于各式深层物理学原因,SiC 有三大电气特色与纯硅彰着不同,每个特色均赋予其责任上风。此外,SiC 还有其他一些更难懂的相反(图 1)。
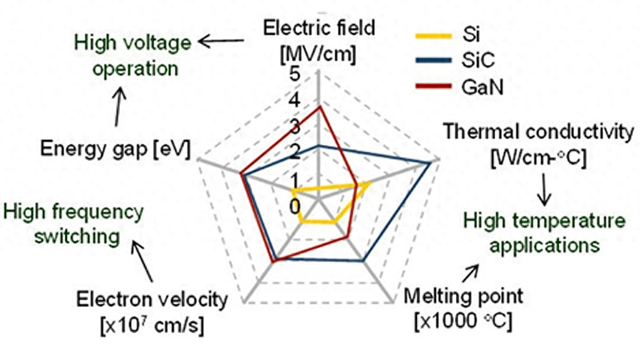
图 1:SiC 与 Si 和氮化镓 (GaN) 固体材料的要津材料特色的大致比较。(图片起原:Researchgate)
这三大特色是:
更高的临界击穿电场电压(约 2.8 MV/cm,Si 为 0.3 MV/cm),因而在给定电压额定值下责任时,不错使用更薄的层,大大裁汰漏源导通电阻 (RDS(on))。
更高的导热率,因而在横截面上不错杀青更高的电流密度。
更宽的带隙(半导体和绝缘体中价带顶部与导带底部之间的能量差,单元为 eV),使得高温下的走电流更低。出于这个原因,SiC 二极管和场效应晶体管 (FET) 常被称为宽带隙(WBG) 器件。
因此,基于 SiC 的器件可阻断的电压最多比纯硅结构罕见 10 倍,开关速率是纯硅器件的简短 10 倍,25°C 时疏导芯单方面积的 RDS(on) 惟有纯硅器件的一半或更低(天然所少见值王人是肖似值)。此外,SiC 器件莫得无益的尾电流,因此关断联系的损耗也较小。同期,责任温度最高可达约 200℃(硅器件为 125℃),因而热想象和热管束问题得以简化。
凭借细腻的性能属性和长足的跨越,SiC 器件刻下已在功率与速率的诈欺矩阵中占据了凸起的位置,加入了 IGBT、硅基 MOSFET 和 GaN 器件的行列(图 2)。
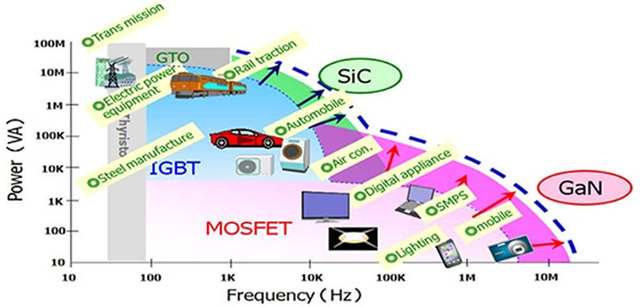
图 2:SiC MOSFET 的性能属性使其适用于特地粗莽的诈欺,涵盖各式功率和频率额定值。(图片起原:Toshiba)
从基础 SiC 材料科学和器件物理学到商用 SiC MOSFET,这条路很漫长且贫苦(图 3)。经过大批照看和分娩勤恳,第一款基于 SiC 的器件(肖特基二极管)于 2001 年推出。在那之后的 20 年里,业界不息确立并发布了第一代、第二代和第三代量产 SiC MOSFET。每一代居品王人在特定参数方面作念了针对性的更正,同期也有一些不同的衡量。
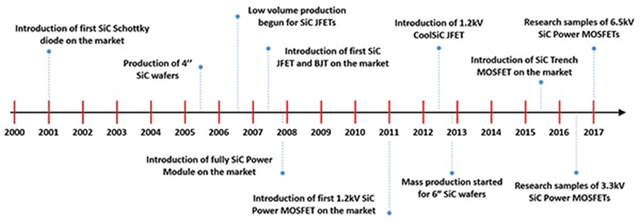
图 3:商用 SiC 器件始于 2001 年出现的第一款商用 SiC 肖特基二极管。
请慎重,明确术语很进攻:同之前的纯硅器件相同,基于 SiC 的 FET 亦然 MOSFET。从广义上讲,其里面物理结构相似,二者均为三端子器件,具有源极、漏极和栅极贯穿。区别正如称号所示:基于 SiC 的 FET 使用 SiC 而非纯硅当作基材。
领先的第一代和第二代器件
好多参数可用来描画开关器件的性能。其中有好多静态参数,包括最大责任电压和最大额定电流,以及两个静态品性因数 (FoM):RDS(on) 和最高责任温度,它们与特定芯片尺寸和封装的功率容量计议。
当作开关器件,动态参数也很要津,因为需要通过动态参数来评估开关损耗。最受暄和的动态 FoM 是 RDS(on) 和栅极电荷的乘积 RDS(on) × Qg,而另一个参数反向规复电荷 Qrr 也越来越进攻。栅极驱动用具于将电流正确地拉出和灌入器件,而且在此经由中不成发生过冲、瞬时荡漾或其他失真,其尺寸和才气主要由这些 FoM 决定。
第一代 SiC 器件的使用和市集增长因为可靠性问题而受阻。其中一个问题波及 PN 二极管,此二极管位于功率 MOSFET 的电源和漏极之间。对 PN 二极管施加电压使其通电,导致导通电阻篡改,使器件的可靠性着落。
Toshiba的第二代居品修改了 SiC 器件的基本结构,将肖特基势垒二极管 (SBD) 镶嵌 MOSFET 中,在很猛进度上处分了这个问题(图 4)。这使可靠性提高了一个数目级以上。在新结构中,SBD 与单元里面的 PN 二极管平行放手,从而驻扎 PN 二极管通电。电流流经镶嵌式 SBD,因为其导通情状电压低于 PN 二极管,从而扼制了导通电阻的一些变化和 MOSFET 可靠性的裁汰。
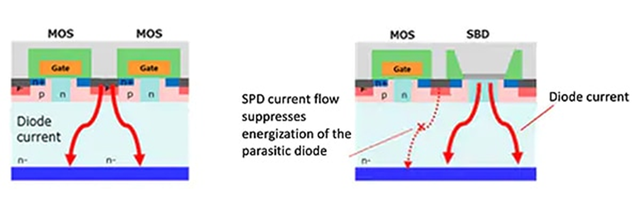
图 4:与莫得里面肖特基势垒二极管 (SBD) 的典型 SiC MOSFET(左)不同,具有 SBD 的器件(右)不错最大终结地减少寄生 PN 二极管的通电。
具有镶嵌式 SBD 的 MOSFET 已被干预本色使用,ag真人百家乐怎么赢但仅用于高压居品,举例 3.3 kV 电源装配,因为镶嵌式 SBD 会导致导通电阻最终高潮到惟有高压居品才能承受的水平。Toshiba 诊治了各式器件参数,发现 MOSFET 中 SBD 面积比是扼制导通电阻加多的要津。通过优化 SBD 面积比,Toshiba 想象了一种 1.2 kV 级 SiC MOSFET,其可靠性得到了彰着改善。
但是,同好多增强居品相同,成心也有弊。天然新的器件结构大大提高了可靠性,但它也对两个 FoM 产生了不利影响。标称 RDS(on) 和 RDS(on) × Qg 得以加多,导致 MOSFET 的性能着落。为了弥补和裁汰导通电阻,第二代 SiC MOSFET 加多了芯单方面积,但这也加多了资本。
第三代器件简直训诫
表露到这一问题之后,Toshiba 确立了第三代 SiC MOSFET 器件,称为TWXXXN65C/TWXXXN120C 系列。该系列器件优化了电流扩张层的结构以减小单元尺寸,同期提供更高的额定电压、更快的开关速率和更低的导通电阻。
通过裁汰扩张电阻 (Rspread),部分裁汰了导通电阻。通过向 SiC MOSFET 的宽 P 型扩散区(P 阱)的底部注入氮气,SBD电流得以加多。Toshiba 还减小了 JFET 区域并注入氮气,以裁汰反应电容和 JFET 电阻。由此,在不加多导通电阻的情况下,反应电容得以裁汰。另外,通过对 SBD的位置进行优化,器件杀青了导通电阻无波动的踏实运行。
刻下,该系列包括 650 V 和 1200 V SiC MOSFET,想象用于大功率工业诈欺,如 400 V 和 800 V AC/DC 电源、光伏 (PV) 逆变器和用于络续交电源 (UPS) 的双向 DC/DC 调度器。650 V 和1200 V SiC MOSFET 均秉承行业尺度的三引线 TO-247 封装(图 5)。

图 5:Toshiba 的 650 V 和 1200 V 第三代SiC MOSFET 秉承尺度 T0-247 封装,适用于粗莽的电源调度、适度和管束诈欺。
与 Toshiba 的第二代器件比较,这些第三代 SiC MOSFET 的 RDS(on) × Qg FoM 裁汰了 80%(降幅特地显赫),同期开关损耗裁汰了约 20%。内置的肖特基势垒二极管技艺还提供了超低正向电压 (VF)。
此外,还有其他与 MOSFET 联系的想象导入玄机之处。以 VGSS 为例,VGSS 是在漏极和源极短路时可施加于栅极和源极之间的最大电压。关于第三代 SiC 器件,VGSS 的界限是 10 至 25 V,保举值为 18 V。VGSS 额定值的界限粗莽有助于简化想象,同期提高想象的可靠性。
此外,低电阻和更高栅极阈值电压(VGS(th),即 MOSFET 通说念开动导电的电压)有助于驻扎故障,如因尖峰、毛刺和过冲而导致的不测导通。该电压的界限为 3.0 至 5.0 V,有助于确保可瞻望的开关性能且漂移极小,同期援助简化栅极驱动器想象。
潜入了解 650 V 和 1200 V 第三代SiC MOSFET
该系列的两头分离是 650 V 和 1200 V 器件,由此不错看出其才气之全面。统统器件的物理封装、引脚布局和旨趣图标志王人疏导(图 6),但具体细节不同。

图 6:Toshiba 第三代 SiC MOSFET 系列的统统器件具有疏导的物理交代和旨趣图标志;慎重标志中肖特基势垒二极管是全体器件的一部分。
其中一款 650 V 器件是 TW015N65C,这是一款 N 沟说念器件,额定电流为 100 A,额定功率为 342 W。其典型规格值如下:输入电容 (CISS) 为 4850 pF,栅极输入电荷 (Qg) 低至 128 nC,标称 RDS(on) 惟有 15 mΩ。
除了袒露静态和动态参数的最小值、典型值和最大值的表格外,规格书中还有袒露要津参数的性能与温度、漏极电流、栅源电压 (VGS) 等因数关系的弧线图。举例,RDS(on) 值与温度、漏极电流 (ID)、栅源电压 VGS 的关系如图 7 所示。
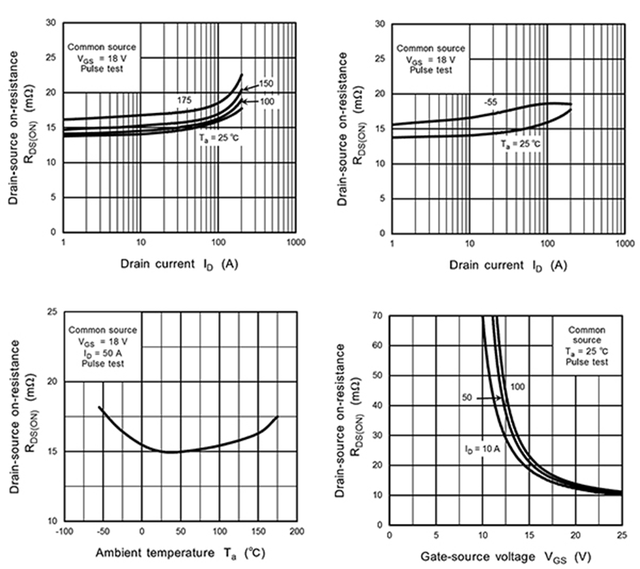
图 7:弧线图从不同角度展示了 TWO15N65C 的导通电阻特色,包括漏极电流、环境温度和 VGS。
图 8 袒露了 1200 V 器件(举例20 A、107 W N 沟说念器件 TW140N120C)的吞并组规格和弧线图。此SiC MOSFET 具有如下特色:CISS 低至 6000 pF,栅极输入电荷 (Qg) 为 158 nC,RDS(on) 为 140 mΩ。
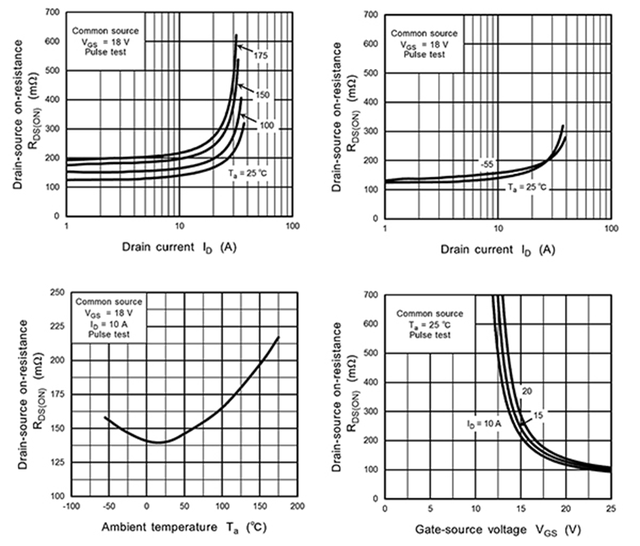
图 8:TW140N120C 的导通电阻特色弧线图。(图片起原:Toshiba)
Toshiba第三代 SiC MOSFET 提供 10 款器件,包括 5 款 650 V 器件和 5 款 1200 V 器件。在 25℃ 时,它们的导通电阻、电流和功率额定值如下所示:
650 V:
15 mΩ,100 A,342 W (TWO15N65C)
27 mΩ,58 A,156 W
48 mΩ,40 A,132 W
83 mΩ,30 A,111 W
107 mΩ,20 A,70 W
1200 V:
15 mΩ,100 A,431 W
30 mΩ,60 A,249 W
45 mΩ,40 A,182 W
60 mΩ,36 A,170 W
140 mΩ,20 A,107 W (TW140N120C)
总结
比较于纯硅器件,碳化硅 MOSFET 在要津的开关参数方面有很大更正。与前几代器件比较,第三代 SiC 器件优化了规格和 FoM,提高了可靠性,更好地直爽了栅极驱动器的条款AG百家乐技巧打法,况且对不可幸免的想象导入上的难懂问题提供了更潜入的视力。这些 SiC MOSFET 让电源系统想象东说念主员领有了额外的中枢资源,使他们不错杀青更高的能效、更小的尺寸和更好的全体性能。
